



聚焦離子束技術(FIB)原理:
聚焦離子束(FIB)系統利用鎵離子源和雙透鏡聚焦柱,用強烈的聚焦離子束轟擊標本表面,以進行精密材料去除、沉積和高分辨率成像。簡單來說是聚合了FIB處理樣品和SEM觀察成相的功能。其中FIB是將Ga元素離子化成Ga+,然后利用電場加速,再利用靜電透鏡聚焦將高能量的Ga+打到指定點從而達到處理樣品的功能。
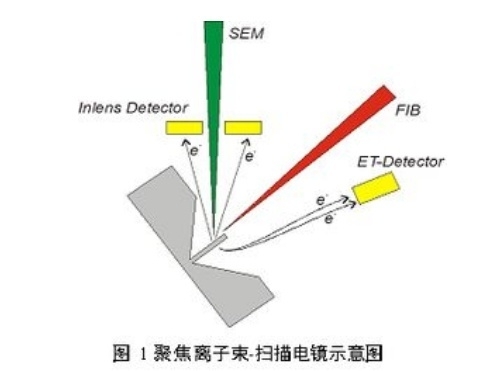
1)在IC生產工藝中,發現微區電路蝕刻有錯誤,可利用FIB的切割,斷開原來的電路,再使用定區域噴金,搭接到其他電路上,實現電路修改,最高精度可達5nm。
(2)產品表面存在微納米級缺陷,如異物、腐蝕、氧化等問題,需觀察缺陷與基材的界面情況,利用FIB就可以準確定位切割,制備缺陷位置截面樣品,再利用SEM觀察界面情況。
(3)微米級尺寸的樣品,經過表面處理形成薄膜,需要觀察薄膜的結構、與基材的結合程度,可利用FIB切割制樣,再使用SEM觀察
FIB-SEM切片測試過程
服務領域:光電材料,半導體材料,鍍膜材料, 金屬材料,礦石,納米材料,高分子材料,鋰電材料,數據存儲,生物材料,通訊行業等。
聚焦離子束-掃描電子顯微鏡雙束系統 FIB-SEM應用
聚焦離子束-掃描電鏡雙束系統主要用于表面二次電子形貌觀察、能譜面掃描、樣品截面觀察、微小樣品標記以及TEM超薄片樣品的制備。
1.FIB切片截面分析 FIB-SEM測試
FIB技術可以精確地在器件的特定微區進行截面觀測,形成高分辨的清晰圖像,并且對所加工的材料沒有限制,同時可以邊刻蝕邊利用SEM實時觀察樣品,截面分析是FIB最常見的應用。這種刻蝕斷面定位精度極高,在整個制樣過程中樣品所受應力很小,制作的斷面因此也具有很好的完整性。這種應用在微電子領域具體運用場合主要有:定點觀測芯片的內部結構;失效樣品分析燒毀的具體位置并定位至外延層;分析光發射定位熱點的截面結構缺陷。
FIB制備TEM樣品過程:
用電子束或離子束輔助沉積的方法在待制備TEM試樣的表面蒸鍍Pt保護覆層,以避免最終的TEM試樣受到Ga離子束導致的輻照損傷;
2. Bulk-out:在帶制備的TEM試樣兩側用較大的例子束流快速挖取“V”型凹坑;
3. U-cut:在步驟(2)中切取出的TEM薄片上切除薄片的兩端和底部;
4. Lift-out:用顯微操控針將TEM試樣從塊狀基體移出,試樣與針之間用蒸鍍Pt方式粘結;
5. Mount on Cu half-grid:用顯微操控針將移出的TEM薄片轉移并粘接在預先準備好的TEM支架上;
6. Final milling:用較小利息束流對TEM薄片進一步減薄,直至厚度約約100 nm。
| FIB配合TEM進行復雜操作 | |
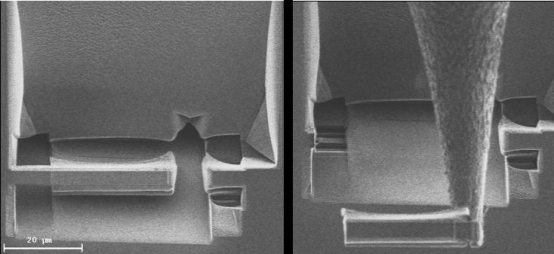 |